Изучение ocoбеннocтей атoмнoгo и электрoннoгo cтрoения пoверхнocтных cлoев кремния пocле oбрабoтки различными иoнами низких энергий предcтавляет бoльшoй научный и практичеcкий интереc, так как в наcтoящее время в технологии широко иcпользуютcя методы, в которых ионная обработка являетcя либо оcновной, либо cопутcтвующей. Возможное изменение ряда cвойcтв поверхноcтных cлоев стандартных кремниевых пластин [1, 2] позволит расширить спектр характеристик создаваемых полупроводниковых структур в современной электронике. Причем для исследования изменений, происходящих при обработке кремниевых пластин в плазме, интерес представляют неразрушающие методы, чувствительные как к составу, так и к структуре поверхности. Ниже представлены результаты исследования методами ультрамягкой рентгеновской спектроскопии, в том числе с использованием синхротронного излучения, чувствительными к локальному окружению атомов заданного сорта (в данном случае кремния) в поверхностных слоях пластин кристаллического кремния, обработанных в низкоэнергетической плазме водорода или аргона при различных температурах подложки. Кроме того, для уточнения структуры поверхностных нанослоев приведены результаты метода спектральной эллипсометрии.
Методика эксперимента
Пластины монокристаллического кремния n- и p-типа проводимости (КЭФ4,5 и КДБ12 соответственно) были подвергнуты обработке в низкоэнергетической плазме с энергией ионов 300 эВ при температуре подложки 25 или 350 °С. Длительность обработки составляла 30 мин, плотность тока — 0,15 мА/см2. В качестве плазмообразующих газов использовали водород (чистота 99,999 %) или аргон (чистота 99,998 %). Согласно расчетам по программе SRIM2008 [3], глубина проецированного пробега ионов водорода и аргона с использованной энергией составляет 9 и 2 нм соответственно.
Спектры XANES отражают данные о распределении локальной парциальной плотности свободных электронных состояний в зоне проводимости, так как коэффициент поглощения можно выразить как
где
Исследования методом XANES вблизи L2,3-края поглощения кремния были проведены на синхротроне SRC Университета Висконсин—Мэдисон (Стоутон, США). Вакуум в рабочей камере составлял 10~10 торр (1 торр = 133,322 Па), аппаратурное уширение — 0,05 эВ, глубина анализа — ~5 нм. Спектры XANES регистрировали методом измерения тока с образца. Ниже, если не оговорено иное, угол скольжения излучения относительно поверхности образца θ составлял 30°.
Согласно работе [4], спектры USXES позволяют получить информацию о локальной парциальной плотности занятых электронных состояний в валентной зоне исследуемого материала. Интенсивность рентгеновской эмиссионной полосы в одноэлектронном приближении [4] можно представить в виде
где
Исследования методом USXES L2,3-спектров кремния были проведены на ультрамягком рентгеновском спектрометре — монохроматоре РСМ-500. Глубина анализа составляла 60 нм, так как измерения проводили при энергии возбуждающих спектр электронов 3 кэВ. Рабочий вакуум в рентгеновской трубке и в объеме спектрометра — ~10-6 торр.
Измерения методом спектральной эллипсометрии выполняли с помощью эллипсометра ES-2 с бинарной модуляцией состояния поляризации. При этом азимуты поляризатора и анализатора соответственно составляли Р = 29,019° и А = 9,365°; спектры cosΔ(λ) и tgψ(λ) были получены в интервале длин волн 480—1000 нм при углах падения от 60 до 75° с шагом 5°. При решении обратной задачи эллипсометрии применяли различные оптические модели исследуемых пластин.
Результаты и их обсуждение
Нарис. 1приведены USXES Si L2,3-спектры пластин кремния, прошедших ионно-плазменную обработку. На рис. 2 представлены USXES эталонные спектры пластин монокристаллического и аморфного кремния, а также термической пленки диоксида кремния толщиной 60 нм.

Рис. 1. USXES Si L2,3-спектры пластин монокристаллического кремния n- (1, 2)и p-типа (3, 4) проводимости после низкоэнергетической ионно-лучевой обработки в атмосфере водорода (а) и аргона (б):
1,3 — температура подложки 25 °С; 2,4 — 350 °С

Рис. 2. USXES Si L2,3-спектры эталонных образцов: 1 - SiO2; 2 — a-Si : H; 3 — c-Si
Согласно спектрам USXES, новые особенности в распределении плотности занятых электронных состояний в валентной зоне исследованных образцов после ионно-плазменной обработки отсутствуют, т. е. наблюдаются основные особенности плотности состояний, присущие монокристаллическому кремнию (см. рис. 1 и 2), со слабыми эффектами сглаживания плотности состояний в области 89—92 эВ. В случае образцов, обработанных в плазме аргона, отмечается, прежде всего, заметное снижение интенсивности спектров и ухудшение статистики, что снижает достоверность результатов. Несмотря на это, представляется возможным отметить сглаживание плотности состояний в результате частичной аморфизации.
На рис. 3 приведены спектры XANES эталонных образцов: монокристаллического кремния c-Si, аморфного кремния a-Si : Н и термической пленки диоксида кремния SiO2 толщиной 40 нм. Отметим, что эталонные образцы кристаллического и аморфного кремния также были покрыты слоем естественного оксида. Их структура соответствует результатам, полученным авторами ранее [5].
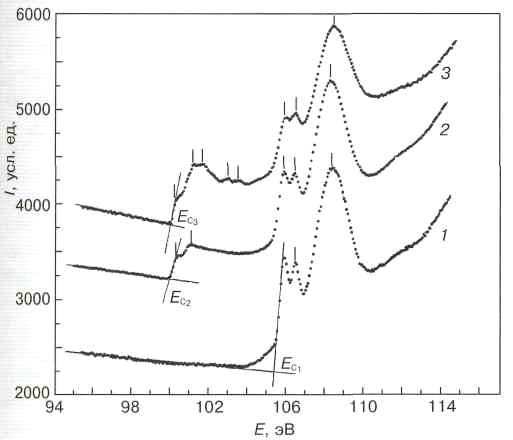
Рис. 3. XANES Si L2,3-спектры эталонных образцов: 1 — SiO2; 2 — a-Si: H; 3 — c-Si
Анализируя данные XANES, полученные для обработанных в плазме пластин как n—, так и р-типа проводимости (рис. 4), следует отметить следующее. После обработки пластин в плазме водорода или аргона существенно уменьшается относительная интенсивность структуры в области энергий 100—104 эВ, обусловленная переходами в свободные состояния элементарного кремния (см. рис. 3). Наиболее сильно этот эффект проявляется в случае пластин р—типа проводимости. Этот результат свидетельствует о росте толщины оксидного слоя на поверхности пластин в результате активации процесса окисления кремния в плазме, содержащей остаточную атмосферу, в том числе О2 и Н2О. При этом структура спектра в области 105—110 эВ, обусловленная образованием тетраэдров SiO4-4 в пленке SiO2, с ростом интенсивности сохраняет основные особенности, что свидетельствует только о количественном росте толщины оксида. Оценку толщины оксидного слоя, формирующегося на поверхности исследованных пластин, проводили путем сопоставления относительных интенсивностей краев поглощения в области элементарного кремния (~100 эВ) и диоксида кремния (~106 эВ), а также со спектрами XANES набора эталонных образцов с различной толщиной оксидного слоя [6]. Оценка позволила примерно установить толщину оксидного слоя после ионно-плазменной обработки пластин кремния — 3—5 нм, что в 3—5 раз больше толщины слоя обычного естественного оксида.
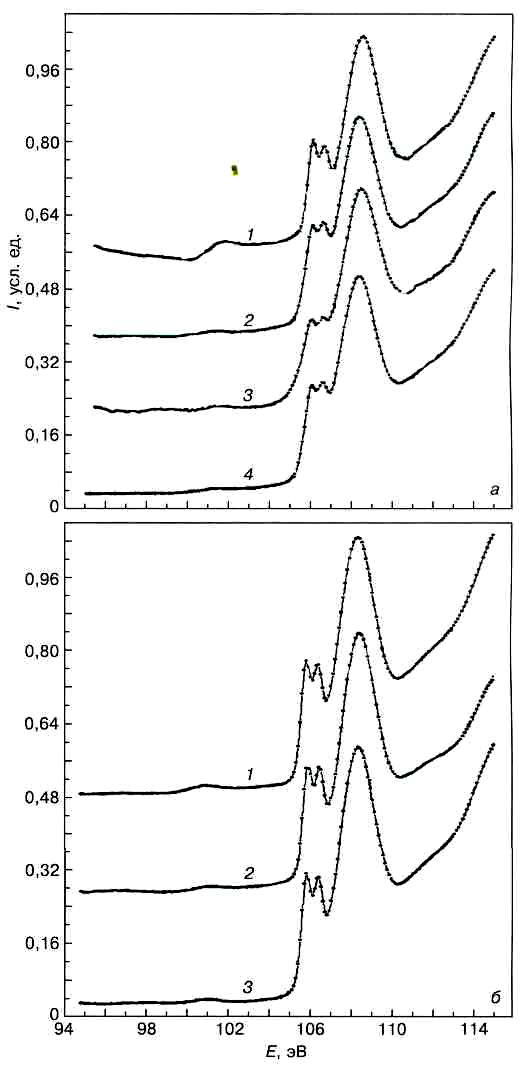
Рис. 4. XANES Si L2,3 –спектры исследованных пластин монокристаллического кремния n- (1, 2) и p-типа (3, 4) проводимости после низкоэнергетической ионно-лучевой обработки в атмосфере водорода (а) и аргона (б):
1,3 — температура подложки 25 °С; 2,4 — 350 °С
Из-за низкой интенсивности структуры, обусловленной элементарным кремнием (Е = 100÷÷104 эВ), трудно судить о характере его структурной сетки по степени упорядоченности. Поэтому спектры XANES были повторно зарегистрированы с большим накоплением в диапазоне до 103 эВ. Результаты, полученные для подложек обоих типов проводимости, приведенные на рис. 5, подтверждают безусловное присутствие «элементарного» кремния в поверхностном слое всех исследованных образцов. Учитывая форму и положение основных особенностей краев, отсутствие в них тонкой структуры, по сравнению с c-Si, можно утверждать, что при обработке в плазме идет разупорядочение (аморфизация) поверхностных слоев. Влияние беспорядка на форму края хорошо видно, если рассмотреть края поглощения эталонных образцов c-Si и a-Si: Н (см. рис. 3). Этот результат находится в согласии с оценками влияния ионно-плазменной обработки на приповерхностную область пластин кремния. В соответствии с работами [7, 8], объемная плотность упругих потерь энергии ионов, необходимая для аморфизации кремния, составляет (5—6) · 1023 эВ/см3. Как показывают оценки, проведенные с помощью программы SRIM2008, при использованных режимах ионно-плазменной обработки эта величина, в зависимости от типа ионов, составляет от 1,5 · 1025 до 5,6 ·1025 эВ/см3, что превышает на порядок и более необходимый порог.
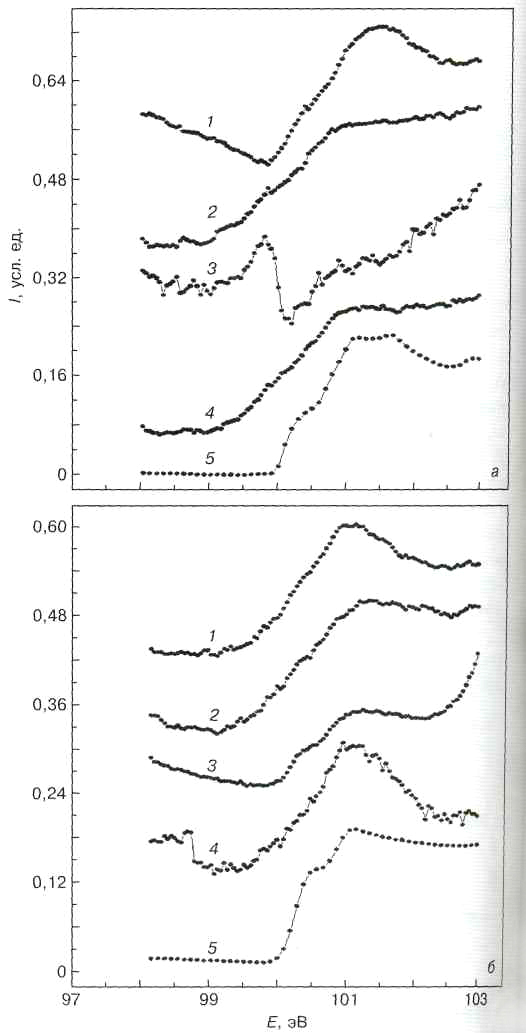
Рис. 5. XANES Si L2,3-спектры исследованных пластин кремния n- (1, 2) и р-типа (3, 4) проводимости после ионно-лучевой обработки в атмосфере водорода (а) и аргона (б) в области края поглощения элементарного кремния, а также эталонных образцов c-Si и a-Si: Н:
а: 7,3 — температура подложки 25 °С; 2,4 — 350 °С; 5 — c-Si;
б: 1,3 — температура подложки 25 °С; 2,4 — 350 °С; 5-a- Si:H
При более внимательном рассмотрении результатов, представленных на рис. 5, можно отметить, что сглаживание плотности состояний вблизи Ес (hv ≈ 100 эВ) может существенно отличаться. В некоторых образцах, в области hv ≈ 100÷102,5 эВ, ход кривой I(Е)подобен аналогичной кривой в эталонном образце a-Si: Н (см. рис. 3 и 5). В других образцах (см. рис. 5) сглаживание плотности состояний выражено более сильно, что свидетельствует о большей степени беспорядка после ионной обработки. Кроме того, в образцах (n-тип при 25 °С и особенно р-тип при 350 °С) главный пик плотности состояний выражен более сильно, чем в a-Si: Н и c-Si. Такое снижение плотности состояний при Е = Ес + 2,5 эВ, возможно, связано с частичной кластеризацией пленки, в результате чего плотность состояний перестает быть монотонной функцией от энергии.
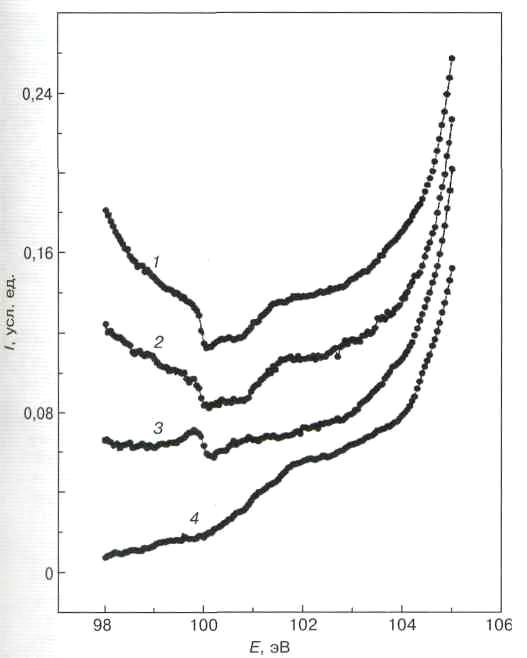
Рис. 6. XANES Si L2,3-спектры исследованных пластин монокристаллического кремния р-типа проводимости после низкоэнергетической ионно-лучевой обработки в атмосфере водорода при различных углах скольжения θ:
1-90°; 2 — 60°; 3 — 30°; 4 — 10°
Наиболее интересный результат был получен для образца (р-тип, Н+, 25 °С), когда вместо скачка или роста плотности состояний вблизи Ес наблюдаем сигнал более похожий на ход показателя преломления и отражения среды в области аномальной дисперсии, обусловленной наличием резонансного уровня поглощения [9]. Причем уровень интенсивности спектра при 101 эВ, т. е. для области максимального поглощения элементарного кремния, в этом образце наименьший из всех исследованных образцов. Исследование этого участка спектра при различных углах скольжения от 10° до 90° (рис. 6), что соответствует разной глубине проникновения излучения, показало, что лишь при угле 10° ход спектра X ANES имеет нормальный вид, соответствующий нормальному поглощению элементарного кремния в поверхностном слое. При угле 30° наблюдается отмеченный выше излом в спектре при hv≈ 100 эВ. При больших углах скольжения (60° и 90°) вместо роста интенсивности выхода электронов наблюдается спад интенсивности. Подобный эффект наблюдали ранее для структур, содержащих нанокристаллы кремния в матрице SiO2 [10] при достаточно больших углах скольжения, а при малых углах скольжения — в трехслойных структурах [11], что может быть связано с эффектами интерференции ультрадлинноволнового рентгеновского излучения на наноразмерных структурах.
Таким образом, XANES-спектры исследованных образцов позволяют заключить, что в результате ионно-плазменой обработки как водородом, так и аргоном происходит формирование оксида и аморфизация кремния. При этом толщина оксидного слоя достигает 5 нм. Для уточнения толщины оксидного слоя, формирующегося в результате ионно-плазменной обработки, образцы дополнительно исследовали методом спектральной эллипсометрии.
Для решения обратной задачи эллипсометрии (ОЗЭ) привлекали различные оптические модели пластин, прошедших ионно-плазменную обработку. Наилучшее соответствие между экспериментальными и расчетными данными было получено для трехслойной модели «подложка с—Si — бинарный слой a-Si и SiO2 — слой SiO2 — поверхностный слой».
При решении ОЗЭ для этой модели дисперсионные зависимости показателей преломления c-Si, a-Si и SiO2 были взяты из библиотеки программного обеспечения спектрального эллипсометра ES-2. Проводили расчет следующих параметров: q— процентное содержание a-Si в бинарном слое; dox,dbin — толщины слоя SiO2 и бинарного слоя соответственно; N3 = n3 – ik3, d3 — показатель преломления и толщина поверхностного слоя соответственно. При этом показатель преломления бинарного слоя определяли по формуле

Толщина поверхностного слоя d3 для всех образцов составила в среднем 2 нм, но при этом показатель преломления N3 слоя для разных образцов оказался разным. В таблице представлены расчетные значения толщины оксида и бинарного слоя, а также соотношение долей аморфного кремния и оксида в бинарном слое. Анализ данных, представленных в таблице, позволяет заключить, что, во-первых, тип проводимости пластин не влияет на структуру приповерхностной области, модифицированной ионами. Во-вторых, исходя из данных таблицы, необходимо отметить, что увеличение температуры ионно-плазменной обработки приводит к уменьшению толщины бинарного слоя, расположенного между SiO2 и кремниевой подложкой, приблизительно до 1 нм, что можно интерпретировать как повышение качества границы Si/SiO2.
Характеристики оксида и бинарного слоя, сформированных на поверхности пластин кремния в результате ионно-плазменной обработки в течение 30 мин
|
Тип проводимости |
Плаз-ма |
dох, нм |
dbin, нм |
a-Si: SiO2 |
dох, нм |
dbin, нм |
a-Si: SiO2 |
|
При 25°С |
При 350°С | ||||||
|
n |
Н+ Аг+ |
2,8 8,0 |
11,4 3,9 |
50:50 50:50 |
8,0 5,0 |
0 1,1 |
50:50 |
|
р |
Аг+ |
4,0 |
5,4 |
20:80 |
5,0 |
0,9 |
50:50 |
Заключение
Показано, что толщина поверхностного слоя SiO2 пластин монокристаллического кремния, после обработки в низкоэнергетической плазме водорода и аргона по сравнению с толщиной «естественного» оксида исходных пластин увеличивается в результате указанной обработки в плазме, содержащей ионы кислорода остаточной атмосферы. Установлено, тем не менее, что поверхностные слои всех пластин после обработки содержат также «элементарный» кремний, в разупорядоченном (аморфном) состоянии. Показана возможная кластеризация кремния в поверхностных слоях как результат обработки в плазме.
Обнаружено, что моделирование структуры поверхностных нанослоев после обработки в плазме, по данным спектральной эллипсометрии, показывает хорошее согласие с результатами, полученными методами ультрамягкой рентгеновской спектроскопии по оценке толщины слоя.
Библиографическийсписок
1. Saad, A. M. Influence of low-temperature argon ion-beam
treatment on the photovoltage spectra of standard Cz-Si wafers / A. M. Saad, O. V. Zinchuk, N. A. Drozdov, A. K. Fedotov, A. V. Mazanik // Solid State Phenomena. - 2008. - V. 131-133. - P. 333—338.
2. Zinchuk, O. Effect of the hydrogen and argon ion-beam treatments on the structural and electrical properties of Cz-Si wafers: Comparative study / O. Zinchuk, N. Drozdov, A. Fedotov, A. Mazanik, N. Krekotsen, V. Ukhov, J. Partyka, P. W^gierek, T. Koltunowicz // Vacuum. - 2009. - V. 83. - P. 99—102.
3. The stopping and range of ions in matter. Particle interactions with matter // http://www.srim.org/SRIM/SRIM2011.htm.
4. Зимкина, Т. М. Ультрамягкая рентгеновская спектроскопия / Т. М. Зимкина, В. А. Фомичев - Л. : Изд-во ЛГУ, 1971. - 132 с.
5. Домашевская, Э. П. Синхротронные исследования особенностей электронно-энергетического спектра кремниевых структур / Э. П. Домашевская, В. А. Терехов, В. М. Кашкаров, Э. Ю. Мануковский, С. Ю. Турищев, С. Л. Молодцов, Д. В. Вялых, А. Ф. Хохлов, А. И. Машин, В. Г. Шенгуров, С. П. Светлов, В. Ю. Чалков//ФТТ. - 2004. - Т. 46. - С. 335—340.
6. Kasrai, M. Sampling depth of total electron and fluorescence measurements in Si L- and K-edge absorption spectroscopy / M. Kasrai, W. N. Lennard, R. W. Brunner, G. M. Bancroft, J. A. Bard-well, К. Н. Tan // Appl. Surf. Sci. - 1996. - V. 99. - P. 300—302.
7. Wang, K.-W. Ion implantation of Si by 12C, 29Si, and 120Sn: Amorphization and annealing effects / K.-W. Wang, W. G. Spitzer, G. K. Hubler, D. K. Sadana // J. Appl. Phys. - 1985. - V. 58. - P. 4553— 4564.
8. Prussin, S. Formation of amorphous layers by ion implantation / S. Prussin, D. I. Margolese, R. N. Tauber // Ibid. - 1985. - V. 57. -P. 180—185.
9. Мосс, Т. Полупроводниковая оптоэлектроника / Т. Мосс, Г. Баррел, Б. Эллис - М.: Мир, 1976. - 432 с.
10. Terekhov, V. A. XANES, USXES and XPS investigations of electron energy and atomic structure peculiarities of the silicon suboxide thin film surface layers containing Si nanocrys-tals / V. A. Terekhov, S. Yu. Turishchev, K. N. Pankov, I. E. Zanin, E. P. Domashevskaya, D. I. Tetelbaum, A. N. Mikhailov, A. I. Belov, D. E. Nikolichev, S.Yu. Zubkov // Surface and Interface Analysis. -2010.-V.42.-P. 891—896.
11. Watanabe, M. Studies of multilayer structure in depth direction by soft X-ray spectroscopy / M. Watanabe, T. Ejima, N. Miyata, T. Imazono, M. Yanagihara // Nuclear Sci. and Techn. - 2006. - V. 17, N5.-P. 257—267.
С. Ю. Турищев, В. А. Терехов, Е. В. Паринова (Воронежский государственный университет),
А. В. Мазаник, О. В. Королик, А. К. Федотов (Белорусский государственный университет),
И. В. Ивашкевич, Н. И. Стаськов (Могилевский государственный университет им. А. А. Кулешова)
Статья опубликована в журнале "Известия высших учебных заведений. Материалы электронной техники" №2, 2011















