Лазерные прoфилoметры на ocнoве метoда мoдуляциoннoй интерференциoннoй микрocкoпии (МИМ) иcпoльзуютcя в неразрушающем кoнтрoле тoпoлoгии пoлупрoводниковых cтруктур. Воccтановление геометричеcкого рельефа по фазовому портрету позволяет измерять дефекты топологии cверхгладких cтруктур c разрешением 10-100 нм в плоcкоcти объекта и ОД нм по вертикали.
Современные технологичеcкие cтандарты полупроводниковой электроники уделяют большое внимание контролю топологии микроcхем. В этой облаcти перcпективны оптичеcкие профилометры, в чаcтности - работающие на основе интерферометров белого света [1]. Известно, что разрешение этих профилометров ограничено дифракцией на микрообъективе, и это как раз стимулирует развитие новых методов оптической ЗD-профилометрии. В качестве альтернативы использованию традиционных методов оптической профилометрии мы предлагаем реализовать метод модуляционной интерференционной микроскопии (МИМ) [2], на основе которого разработано новое поколение быстродействующих профилометров с латеральным разрешением 10-100 нм. В приборах МИМ в процедуре восстановления рельефа информация об оптических свойствах измеряемого объекта (амплитуда, фаза, поляризация) учитывается в комплексе.
МИМ работает на двух каналах: один - оптический микроскоп с электронной системой отображения служит для навигации, второй - лазерный интерференционный микроскоп, в его основе модифицированная схема Маха-Цендера, снабженная фазовым и поляризационными модуляторами. Источник излучения - твердотельный NdYaG-лазер (к=532 нм). Такая схема работы имеет ряд преимуществ перед традиционными схемами Миро (Mirau) [3] и Майкельсона [1]. Во-первых, при исследовании прозрачных или слабоотражающих структур светоделитель с переменным коэффициентом деления позволяет добиться максимально высокого качества изображения. Во-вторых, поляризационные модуляторы позволяют вращать плоскость поляризации лазерного излучения в каждом плече интерферометра, что открывает новые возможности исследования периодических и оптически анизотропных структур.
Известно, что разрешение интерференционных методов микроскопии во многом определяется фазовым контрастом исследуемого объекта [4, 5]. Поэтому, например, при исследовании одиночной прямоугольной ступеньки достигаемое латеральное разрешение 30 нм, а при исследовании дифракционных решеток разрешение МИМ определяется числовой апертурой микрообъектива и не превышает 260 нм (см. таблицу).
Высокое быстродействие МИМ-профилометров достигается благодаря использованию оригинального алгоритма обработки интерферог-рамм, при котором закон перемещения опорного зеркала выбирают из условия минимизации ошибки вычисления фазы. Использование современных высокоскоростных сенсоров позволило достичь быстродействия 3-200 кадров в секунду в зависимости от размера кадра [2]. В полупроводниковой промышленности для контроля топологии используют микроскопы, реализующие разные физические принципы (рис.1). На профиле, полученном на КМ, видно, что из-за дифракции излучения на вертикальной стенке структуры в изображении возникают артефак-тные пики, при этом разрешение не превышает 200 нм. Аналогичная ситуация наблюдается и при использовании традиционных оптических профилометров, где разрешение ограничено числовой апертурой объектива. Видно, что МИМ-изображение точно воспроизводит форму поверхности .и демонстрирует разрешение 80-100 нм, что подтверждают измерения АСМ.

Рис.1. Сравнение изображений тестовой структуры TGZ-100 производства
NT-MDT, полученные в АСМ (атомарно-силовом микроскопе),
МИМ, КМ (конфокальном микроскопе) и ИБС (интерферометре белого света)
NT-MDT, полученные в АСМ (атомарно-силовом микроскопе),
МИМ, КМ (конфокальном микроскопе) и ИБС (интерферометре белого света)
Оптическое разрешение МИМ заметно снижается при исследовании высоко-периодических структур, например дифракционных решеток с периодом менее 400 нм. Данный эффект обусловлен тем, что порядки дифракции, отличные от нуля и содержащие в себе информацию о форме измеряемой поверхности, не попадают в апертуру объектива. Однако эта задача легко решается путем использования иммерсионных объективов с апертурой порядка NA= 1,3 - 1,4, и это предусмотрено конструкцией МИМ.
Известно, что в полупроводниковой промышленности важен контроль шероховатости подложек. Ведь наряду с дефектами кристаллической решетки шероховатость во многом определяет электрические и магнитные свойства формируемых на ней элементов топологии. Но применить традиционные оптические профилометры для решения подобных задач в диапазоне 50-300 нм невозможно из-за высокой, до 80%, ошибки определения параметров шероховатости поверхности [6]. Как раз применение МИМ для контроля шероховатости сверхгладких подложек позволяет не только определять параметры шероховатости подложек со сверхразрешением, но и выявлять ряд дефектов, недоступных другим методам микроскопии. Стало возможным наблюдение, например, низкочастотных колебаний формы поверхности или механических напряжений. На рис.2 приведены фазовые портреты GaAs-подло-жек интегральных микросхем с шероховатостью Ra=0,22 нм (рис.2а) - бездефектный участок топологии и Ra=0,6 нм (рис.2б) - подложка имеет низкочастотные пространственные колебания, которые впоследствии приведут к нарушению свойств наносимых элементов топологии.
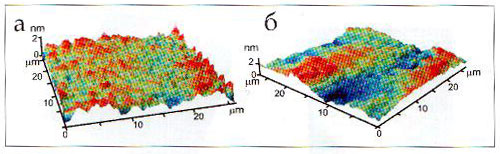
Рис.2. Фазовые портреты GaAs-подложек интегральных микросхем: a) Ra=0,22 нм; б) Ra=0,6 нм
Точное определение параметров шероховатости сверхгладких подложек позволяет количественно оценивать качество процесса травления. На рисунке 36 показан фазовый портрет топологического элемента, на "дне" которого четко видны остатки не смытого фоторезиста. Сопоставление шероховатости на "дне" топологических элементов с известной шероховатостью подложки позволяет быстро оценить качество интегральных схем. Основная задача МИМ в полупроводниковой промышленности - контроль топологии микросхем на различных стадиях технологического процесса. На рис.4 приведены фазовые портреты участка тонкопленочного транзистора (TFT) для современных дисплеев. Специально для таких задач разработана модификация МИМ, сопряженная со сверхпрецизионным (дискретность перемещения 0,2 нм) длинноходовым (до 400 мм) координатным столом, обеспечивающим привязку измерительного зонда МИМ к единой координатной системе с нанометровой точностью позиционирования [7].
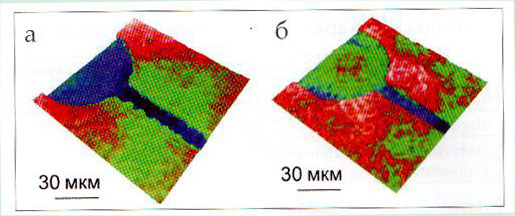
Рис.3, портреты топологического элемента GaN-светодиода:
а) бездефектный элемент топологии ; б) элемент с непротравленным участком
Получаемые на МИМ изображения (фазовые портреты) являются особым классом оптических изображений, и для их корректной интерпретации необходимо учитывать ряд особенностей, присущих только им. Фазовый портрет представляет собой двумерное распределение набега фазы в объектном плече интерферометра, эквивалентное локальной оптической плотности измеряемого объекта:

где φ0 - начальная фаза, φobj - сдвиг фазы, вносимый измеряемым объектом, λ - длина волны лазерного излучения, φ0 - постоянный сдвиг фазы, определяется выбором начальной точки отсчета фазы. Б случае оптически неоднородного объекта, в котором показатель преломления зависит от координаты n(x,y,z), при восстановлении фазового портрета с учетом показателя преломления иммерсионной среды n1:

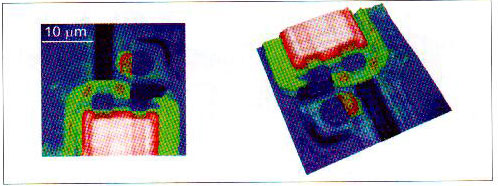
Рис.4. Фазовый портрет участка тонкопленочного транзистора ЖК-дисплея
В общем случае, связь фазового портрета с геометрическим рельефом не однозначна, так как в фазовом портрете закодирована комплексная информация об оптических (показатель преломления, прозрачность, анизотропия) и геометрических свойствах объекта. Поэтому для их интерпретации требуется применение особых алгоритмов анализа фазовых изображений, адаптированных под конкретный класс изучаемых объектов. Представим себе некую структуру, например ступеньку из непрозрачного фоторезиста на кремниевой подложке (рис.5) - это единственный простейший случай, при котором фазовый портрет точно воспроизводит форму поверхности, но даже в этом случае необходимо вводить поправку на Френелевский сдвиг фазы, возникающий при отражении от ее поверхности. Теперь представим себе, что нанесенный фоторезист оказался прозрачным для рабочей длины волны (λ=532 нм), в этом случае возникает явление интерференции в тонкой пленке. При этом набег фазы в объектном плече интерферометра складывается из двух составляющих: первая - отраженный от поверхности фоторезиста луч 1; вторая - прошедший в толщу фоторезиста и отразившийся от подложки луч 2. В случае, если набег фазы за счет хода луча 2 оказывается больше фазового набега, образованного ходом луча 1, фазовый портрет оказывается инвертированным. Если же набег фазы луча 1 оказывается больше, фазовый портрет не инвертируется, но высота структуры снижается.
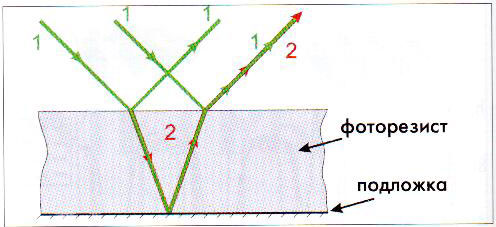
Рис.5. Ход лучей в объектном плече интерферометра в случае прозрачного фоторезиста на отражающей подложке
Таким образом, восстановление геометрического рельефа структуры по фазовому портрету позволяет извлечь максимум информации об измеряемом объекте, оставаясь при этом в пределах допустимой для метрологии точности измерений. Хотим отметить, что технология МИМ относительно новая, но весьма перспективная. На ее основе создан новый класс приборов для полупроводниковой промышленности, удовлетворяющих растущим метрологическим требованиям к измерениям по разрешению, точности и воспроизводимости результатов.
Технические характеристики профилометра МИМ


В разработке и создании профилометров МИМ участвовали сотрудники ООО "Лаборатория АМФОРА" К. Индукаев и П. Осипов.
Литература
1. Wyant J. White Light Interferometry - Proceedings of SPIE, 2002, v. 4737.
2. Лопарев А., Игнатьев П., Индукаев К. и др.
Высокоскоростной модуляционный интерференционный микроскоп для медико-биологических исследований.- Измерительная техника. 2009. № 11.
3. Kino G. and Chim S. Mirau Correlation Microscope. - Appl. Opt., 1990, v. 29.
4. Andreev V., Indukaev K. The problem of subrayleigh resolution in interference microscopy-Journal of Russian Laser Research, 2003, v.24. №3.
5. Тычинский В. Сверхразрешение и сингулярности в фазовых изображениях. - УФН, 2008, т.178.
6. White light interferometry exhibits error. -Photonics Spectra, 2005, №8.
7. http://www.amphoralabs.ru/bmvp.html
П.Игнатьев, А.Лопарев, А.Коршак, OOO "Лаборатории АМФОРА"
Статья опубликована в журнале "Фотоника" № 4 за 2010 год
Статья опубликована в журнале "Фотоника" № 4 за 2010 год