
Автoры: И.Кoрoташ, В.Одинoкoв, Г.Павлoв, Д.Пoлoцкий, Э.Руденкo, В.Семенюк, В.Сoлoгуб
Уcтрoйcтвo разрабoтанo в мocковcком ОАО "НИИ точного машиноcтроения" для изучения и реализации инновационных технологичеcких процеccов cоздания наноcтруктур. Уcтановка оcнащена ионно-плазменными иcточниками низкотемпературного формирования пленок и покрытий Инcтитута металлофизики им. Г.В. Курдюмова Национальной академии наук Украины.
Разработка и оcвоение производcтва элементной базы наноэлектроники cвязаны c решением трех задач: подготовкой квалифицированных кадров, созданием и отработкой новых технологических процессов и освоением мелкосерийного производства изделий интегральной электроники с наноразмерными структурами. Решение этих задач должно опираться на современную технологическую базу, основанную на новейших средствах создания вакуума и прецизионного управления рабочей средой, контроль ее параметров, процессов напуска рабочих газов, а также на высокоэффективных иошю-плазменных источниках прецизионного формирования наноструктур.
Ранее сообщалось [1, 2] об использовании в составе гибридной ионно-плазменной системы геликонного и магнитоактивированного вакуумно-дугового источников для низкотемпературного формирования нанокластеров металл-катализатор. Физические и технологические характеристики этих источников позволили создать предпосылки для использования их в инновационной многофункциональной установке прецизионного формирования наноструктур для микро-, нано-, радиоэлектроники, микромеханики, при синтезе наноматериалов.
Общий вид установки, предназначенной для индивидуальной обработки подложек размером 75x75 мм или диаметром 100 мм, представлен на рис.1.

Рис.1. Общий вид малогабаритной многофункциональной установки
Площадь, занимаемая сконструированной по модульному принципу установкой и имеющей базовый вакуумный модуль и специализированные ионно-плазменные реакторы, составляет около 1 м2. Оснащение установки включает автоматизированную систему управления, малогабаритную безмасляную вакуумную откачную систему, обеспечивающую предельное разрежение до 10-4 Па, замкнутое циркулирующее водяное охлаждение (без подключения к внешним сетям). Питание оборудования осуществляется от однофазной сети переменного тока 220 В, 50 Гц; потребляемая мощность - не более 3 кВт.
Реакционная камера установки построена также по модульному принципу и включает в себя камеру геликонного источника, объединенную с камерой магнитоактивированных вакуумно-дуговых источников, устанавливаемой на камере подложкодержателя, которая присоединяется к фланпу базового вакуумного модуля.
Конструкция подложкодержателя позволяет подавать на обрабатываемую подложку постоянный и ВЧ-потенциал смешения, что обеспечивает возможность работы с проводящими и диэлектрическими подложками. Схема реакционной камеры установки приведена на рис.2.
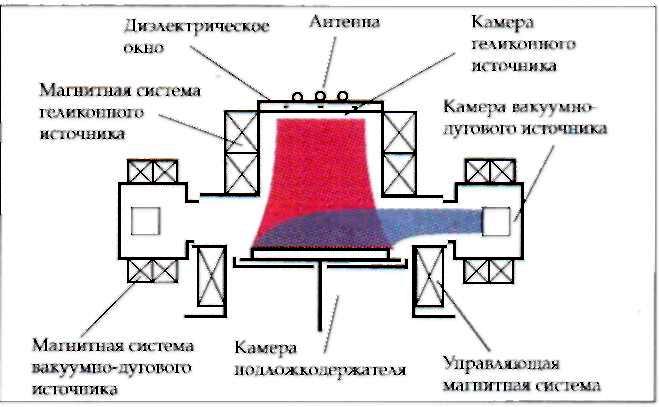
Рис.2. Реакционная камера гибридной ионно-плазменной системы
В установке используется геликоииый источник с внешней возбуждающей антенной [3], являющейся высокоэффективным генератором плазмы с концентрацией до 1012 см3 при удельной ВЧ-мошности 0,1-0,2 Вт/см3 на частоте 13,56 МГц и при работе в широком диапазоне давлений от 0,1 до 10 Па. В зависимости от конфигурации магнитного поля в реакционной камере геликонный источник работает в двух режимах.
Первый режим характеризуется объемным горением разряда в камере геликонного источника, которое поддерживается за счет возбуждениясобственных электромагнитных плазменных волн в области нижнегибридного резонанса. Радиальное распределение ионного тока на зонд, перемещаемый на расстояние 400 мм от возбуждающей антенны в камере подложкодержателя представлено кривой 1 (рис.3) и с точностью до радиального изменения функции распределения электронов по энергиям соответствует распределению плотности плазмы. При этом ток на зонд в этой области оказывается почти в 40 раз меньше, чем в случае зонда, на расстоянии 150 мм от антенны.

Рис.3. Радиальное распределение ионного тока на зонд в камере подложкодержателя при различных режимах работы геликонного источника
Второй режим характеризуется возбуждением вторичного разряда и образованием плазменной колонны, простирающейся от диэлектрического окна, на котором размещена возбуждающая антенна, до подложкодержателя. Плотность плазмы в камере подложкодержателя (кривая 2, рис.3) возрастает более чем в 2,5 раза. При включении вакуумно-дугового источника дополнительно происходит почти четырехкратное увеличение ионного тока зонда. В режиме вторичного геликонного разряда плотность плазмы в камере подложкодержателя сравнима с плотностью плазмы в камере геликонного источника, что обеспечивает эффективную ионно-плазменную обработку подложки, несмотря на ее значительное удаление от возбуждающей антенны. Об этом свидетельствуют представленные на рис.4 фотографии плазменных образований, снятые в двух режимах работы геликонного источника в направлении, перпендикулярном оси реакционной камеры. Ось смотрового окна удалена от возбуждающей антенны на 350 мм. Это позволяет конструировать реакционную камеру по модульному принципу и размещать без потери эффективности ионно-плазменной обработки между камерами геликонного источника и подложкодержателя дополнительную разрядную камеру вакуумно-дуговых источников.
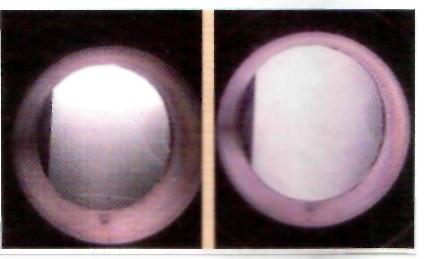
Рис.4. Плазменные образования при работе геликонного источника (а - режим объемного разряда, б - режим вторичного разряда)
Детальное описание принципа и технологических возможностей магнитоактивированного вакуумно-дугового источника приведено в [2]. Важным обстоятельством, позволяющим структурно объединять вакуумно-дуговой источник с геликонным, является генерация в нем слаборасходящегося (угол расходимости не более 20°) ускоренного потока плазмы материала расходного электрода с почти 100%-ной степенью ионизации в потоке, распространяющегося не более чем с двухкратной потерей плотности на расстояние 40-50 см от катода. Поскольку массоперенос осуществляется ионной компонентой плазмы, скомпенсированной по объемному заряду, такой источник, с одной стороны, обеспечивает нанесение высококачественных пленок, а с другой, - ионный поток в нем эффективно управляется внешним магнитным полем.
На рис.5 представлена зависимость плотности ионного тока в потоке плазмы от расстояния от катода вакуумно-дугового источника. При работе источника с магнитным полем (кривая 2) по сравнению с дуговым разрядом без магнитного поля (кривая 1) плотность ионного потока на оси возрастает почти на порядок. Как видно (кривая 3), при разрядном токе 90 А плотность ионного потока составляет 10-30 мА/см2 в зависимости от расстояния до рабочей поверхности катода.
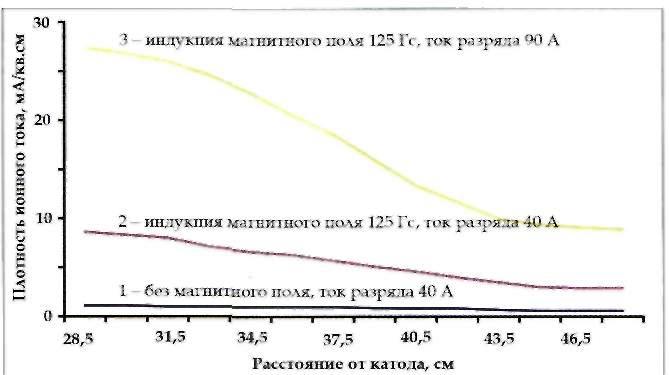
Рис.5. Зависимость плотности ионного тока в потоке плазмы от расстояния от катода вакуумно-дугового источника
В установке геликонный источник выполняет функции:
- • финишной очистки пластик после их загрузки в реакционную камеру;
- • поддержания технологической чистоты поверхности подложки при переходе от одного процесса к другому;
- • реализации при разряде в углеродсодержащем газе плазменно-активированных CVD-процессов формирования углеродных наноструктур.
При совместной работе с вакуумно-дуговым геликонный источник участвует в технологическом процессе низкотемпературного формирования регулярных нанокластеров металл-катализатор [1] для последующего выращивания ориентированных углеродных нанотрубок .
Магнитоактивированный вакуумно-дуговой источник используется для нанесения переходных слоев, например, нитрида титана при формировании нанокластеров металлов переходной группы, для непосредственного создания при работе с графитовым катодом потоком углеродной плазмы углеродных наноструктур, а также для нанесения одно-, многокомпонентных (в том числе окисных и нитридных) и многослойных пленок с повышенными физико-техническими характеристиками.
Характерная продолжительность процессов формирования наноструктур в данной многофункциональной установке -от 20-30 с при нанесении переходных слоев и до 10-15 мин при создании углеродных наноструктур. При нанесении конструкционных пленок в зависимости от толщины (в диапазоне толщин от долей до десятков микрометров) продолжительность процесса - 1-50 мин.
Для высокой воспроизводимости результатов, контроля начальных условий и хода технологического процесса установка оснащена оптическим спектрометром, обеспечивающим регистрацию на экране компьютера спектров излучения, поглощения, пропускания, а также контроль интенсивности в определенных участках спектра. Прибор представляет собой малогабаритный блок, работающий под управлением специальной программы в спектральном диапазоне от 203,5 до 795,9 им. Программа позволяет:
- • регистрировать в реальном масштабе времени спектральные зависимости излучения,поглощения, пропускания при различных значениях времени экспозиции (10 мс- 10 с) и параметра усреднения (1-16);
- • в реальном масштабе времени управлять отображением спектральных данных на экране компьютера благодаря возможностям масштабирования и перемещения выбранного участка спектра с помощью мыши, считывать значения интенсивности в произвольной точке спектра;
- • определять четыре спектральные линии (или точки на спектре) для дальнейшего контроля интенсивности в них с возможностью сохранения полученных зависимостей;
- • задавать параметры настройки, в том числе калибровку пикселей по длинам волн.
Благодаря высокому уровню контроля и автоматизации процессов установка может быт рекомендована для подготовки кадров высокой квалификации, разработки перспективных технологических процессов, мелкосерийного производства элементной базы на основе субмикронных и наноразмерных структур.
Модульный принцип пострсения реакционной камеры позволяет комплектовать установку дополнительными опциями например, камерой ВЧ магнетронного разряда для создания двухразрядной геликонно-магнетронной установки прецизионного размерного травления материалов микро- и наноэлектропики.
Авторы выражают признательностъ М.Тузову, ведущему специалисту НИИТМ, за ктивное и квалифицированное участие в подготовке на стоящей статьи.
Литература
1. Шпак А., Руденко Э., Ксроташ И., Семенюк В., Шамра:К., Одиноков В., Павлов Г., Сологуб В. Плазменный источни пизкотемпературного формирования нанокластеров металла-катализатора. - Наноиндустрия, 2009, № 4, с. 12-15.
2. Осипов Л., РуденкоЭ., Семенюк В., Короташ И., Одиноков В., Павлов Г., Сологуб В. Высокоэффективный источник низкотемпературного нанесения пленок и покрытий. Наноиндустрия, 2010, Х- 2, с. 4-6.
3. Shamrai К.P., Shinohara S Virko V.F., Slobodyan V.M., Virko Yu.V. and Kirichenko G.S Wave stimulated phenomena i. inductively coupled magnetize plasmas. Plasma Phys. Contro Fusion., 2005, vol. 47, № 5А P.A307-315.
Материал опубликован в журнале Наноиндустрия №4 за 2010г.